半导体工艺与设备-1 集成电路制造工艺
一 关于集成电路
1.1 集成电路的概念与诞生
集成电路(Integrated Circuit,IC):是指通过一系列特定的加工工艺,将晶体管、二极管等有源器件和电阻器、电容器等无源元件,
按照一定的电路互连,“集成”在半导体(如硅或砷化镓等化合物)晶片上,然后封装在一个外壳内,从而执行特定功能的电路或系统。
1958年,在德州仪器(Texas Instruments,TI)负责电子装备小型化工作的基尔比(Jack Kilby)提出了集成电路的设想:
“由于电容器、电阻器、晶体管等所有部件都可以用一种材料制造,我想可以先在一块半导体材料上将它们做出来,然后进行互连而形成一个完整的电路。”
1958年9月12日和9月19日,基尔比分别完成了移相振荡器和触发器的制造和演示,标志了集成电路的诞生。
2000年,基尔比被授予诺贝尔物理学奖。诺贝尔奖评审委员会曾评价基尔比“为现代信息技术奠定了基础”。
下图为基尔比和他的集成电路专利:

1.2 半导体制造技术的发展
下图为半导体制造技术发展阶段图:

1.3 集成电路产业链
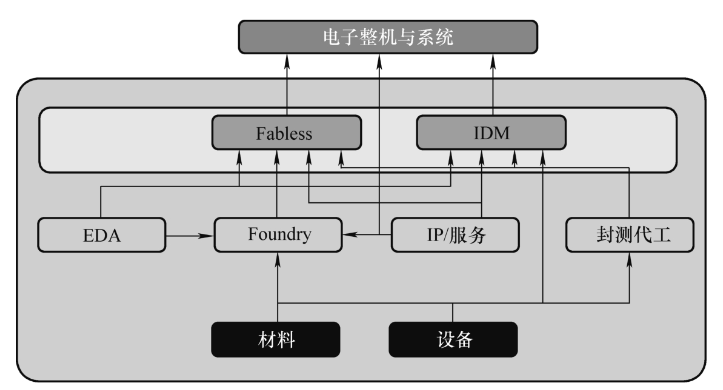
半导体产业链(以集成电路为主,含分立器件)的构成如上图:
- Fabless:无生产线设计企业;
- IDM:Integrated Device Manufacturer,集成器件制造商;
- IP :电路模块厂商;
- EDA:Electronic Design Automatic,电子设计自动化,企业主要提供设计工具;
- Foundry;晶圆代工厂,提供芯片制造代工服务;
- 封测代工公司:主要为Fabless和IDM服务;
- 材料和专用设备公司:主要为芯片制造企业提供所需要的材料和设备。
利用半导体技术生产的主要产品是集成电路和半导体分立器件。
集成电路的主要产品包括:
- 专用标准产品(Application Specific Standard Parts,ASSP);
- 微处理器(Microprocessor Unit,MPU);
- 存储器(Memory);
- 专用集成电路(Application Specific Integrated Circuit,ASIC);
- 模拟电路(Analog Circuit);
- 通用逻辑电路(Logical Circuit)。
半导体分立器件的主要产品包括:
- 二极管(Diode);
- 晶体管(Transistor);
- 功率器件(Power Device);
- 高压器件(High-Voltage Device);
- 微波器件(Microwave Device);
- 光电器件(Optoelectronics);
- 传感器件(Sensor)。
二 集成电路制造工艺
2.1 芯片制造
一片硅晶圆片上可以同时制作几十甚至上万个特定的芯片,一片硅片上芯片数的不同取决于产品的类型和每个芯片的尺寸。
硅晶圆片通常被称为衬底。硅片的直径多年来一直在增大,从最初的不到1in到现在常用的12in(约300mm),且正在进行向14in或15in的转变。
芯片的制造一般分为5个阶段:硅片制备、硅片制造、芯片的测试/拣选、装配与封装、终测。
(1) 硅片制备:
制作原料,将硅从沙中提炼并纯化。经过特殊工艺产生适当直径的硅锭。然后将硅锭切割成用于制造微芯片的薄硅片。
按照专用的参数规范制备硅片,例如定位边要求和沾污水平。

(2) 硅片制造:
又称芯片制造,裸露的硅片到达硅片制造厂,然后经过各种清洗、成膜、光刻、刻蚀和掺杂步骤。加工完的硅片具有永久刻蚀在硅片上的一整套集成电路。
(3) 硅片的测试与挑选:
硅片制造完成后,硅片被送到测试/拣选区,在那里进行单个芯片的探测和电学测试。然后拣选出可接受和不可接受的芯片,并为有缺陷的芯片做标记。
(4) 装配与封装:
硅片测试/拣选后,硅片进入装配与封装步骤,以便把单个芯片包装在一个保护管壳内。硅片的背面进行研磨以减少衬底的厚度。
一片厚的塑料膜被贴在每个硅片的背面,然后,在正面沿着划片线用带金刚石尖的锯刃将每个硅片上的芯片分开。
硅片背面的塑料膜保持硅芯片不脱落。在装配厂,好的芯片被压焊或抽空形成装配包。稍后,将芯片密封在塑料或陶瓷壳内。
(5) 终测:
为了确保芯片的功能,要对每一个被封装的集成电路进行测试,以满足制造商的电学和环境的特性参数要求。终测后,芯片被发送给客户以便装配到专用场合。
2.1 工艺划分
集成电路制造工艺一般分为:
-
前段:前段工艺一般是指晶体管等器件的制造过程,主要包括隔离、栅结构、源漏、接触孔等形成工艺。
-
后段:后段工艺主要是指形成能将电信号传输到芯片各个器件的互连线,主要包括互连线间介质沉积、金属线条形成、引出焊盘形成等工艺。
- 中段:为了提高晶体管的性能,45nm/28nm以后的先进技术节点采用了高介电常数栅介质及金属栅极工艺,在晶体管源漏结构制备完成后增加替代栅工艺及局部互连工艺。这些工艺介于前段工艺与后段工艺之间,均为传统工艺中未采用的工艺,因此称为中段工艺。
通常,前段工艺与后段工艺之间以接触孔制备工艺为分界线。
-
接触孔:是为连接首层金属互连线和衬底器件而在硅片垂直方向刻蚀形成的孔,其中填充钨等金属,其作用是引出器件电极到金属互连层;
-
通孔:是相邻两层金属互连线之间的连接通路,位于两层金属中间的介质层中,一般用铜等金属来填充。
广义上的划分:
-
前道工序:广义的集成电路制造还应包括测试、封装等步骤。相对于测试和封装,元器件和互连线制造均为集成电路制造的前一部分,统称为前道工序;
-
后道工序:测试和封装则称为后道工序。
如下图所示:
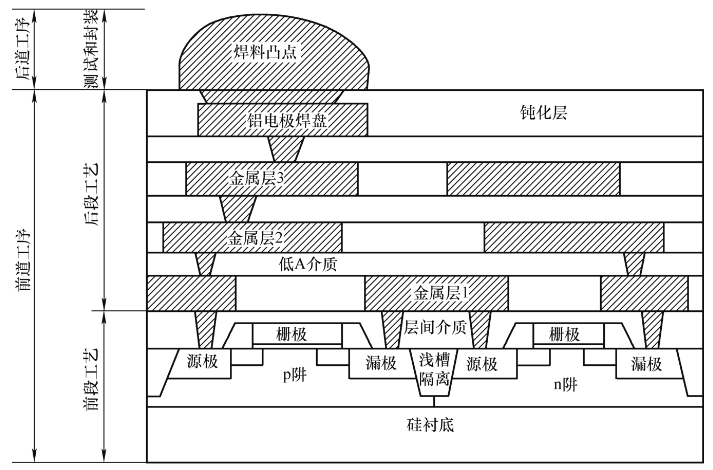
三 附录
SMIF:Standard Mechanical Interface
AMHS:Automated Material Handing System
OHT:Overhead Hoist Transfer
FOUP:Front Opening Unified Pod,Exclusive to 12 inch(300mm) wafers
__ 以 上 __


 浙公网安备 33010602011771号
浙公网安备 33010602011771号