allegro封装制作总结
1、0805封装的制作(贴片分立元件)
1.1、制作焊盘
1.1.1、计算焊盘尺寸
对于0805来说,贴片电阻和贴片电容的封装是一样的,首先计算PCB焊盘的宽度X,高度Y和总长度G。
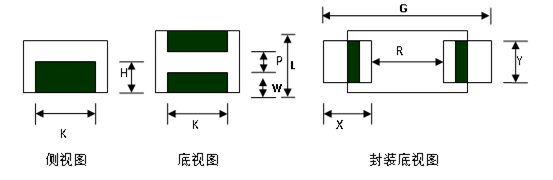

因为我们制作0805封装,所以PCB焊盘宽度X = 1.20mm,PCB焊盘高度Y = 1.40mm,PCB总长度G = 3.20mm。
1.1.2、制作焊盘
Begin Layer(Top层):Regular Pad选择Rectangle,Width=1.20mm,Height=1.40mm;
SOLDERMASK_TOP(绿油层):Regular Pad选择Rectangle,Width=1.2mm+420mil(0.1mm0.5mm),
Height=1.4mm+4~20mil (0.1mm~0.5mm) ;
PASTEMASK_TOP (钢网层) :Regular Pad选择Rectangle,Width=1.2mm,Height=1.4mm;
其他层不用考虑,设置界面如下图所示。
之后保存为焊盘文件r0805_1mm2_1mm4.pad。
1.2、制作封装
1.2.1、各层的尺寸约束
表贴封装必须包含的层:
- 元件实体范围(Place_bound)
含义:表明在元件在电路板上所占位置的大小,防止其他元件的侵入,若其他元件进入该区域则自动提示DRC报错。
形状:分立元件的Place_bound一般选用矩形。
尺寸:元件体以及焊盘的外边缘+10~20mil,线宽不用设置,一般画封装画个大概就行,不用特地计算 - 丝印层(Silkscreen)
含义:用于注释的一层,这是为了方便电路的安装和维修等,在印刷板的上下两表面印刷上所需要的标志图案和文字代号等,例如元件标号和标称值、元件外廓形状和厂家标志、生产日期等等。
形状:分立元件的Silkscreen一般选用中间有缺口的矩形。若是二极管或者有极性电容,还可加入一些特殊标记,如在中心绘制二极管符号等。
尺寸:比Place_bound略小(0~10 mil),线宽可设置成5mil(0.1mm~0.2mm)。 - 装配层(Assembly)
含义:用于将各种电子元件组装焊接在电路板上的一层,机械焊接时才会使用到,例如用贴片机贴片时就需要装配层来进行定位。
形状:一般选择矩形。不规则的元件可以选择不规则的形状。需要注意的是,Assembly指的是元件体的区域,而不是封装区域。
尺寸:一般比元件体略大即可(0~10mil),线宽不用设置。
1.2.2、设置参数、栅格grid和原点
打开PCB_Editor,File->new,选择Package symbol并设置好存放路径以及封装名称
Setup->Design Parameter设置单位,图纸大小、栅格等,Setup ->Changing Drawing Origin,使用命令窗口可以重新设置原点。
1.2.3、放置焊盘
Setup->User Preferences->Paths->Library->padpath中设置要使用的焊盘路径
Layout->Pins,并在options中选择好配置参数,在绘图区域放置焊盘。放置时可以使用命令来精确控制焊盘的位置
1.2.4、放置各类标识
放置元件实体区域(Place_Bound)
- Place_Bound的尺寸:焊盘的外边缘+10~20mil,线宽不用设置。
放置丝印层(Silkscreen)
- 丝印的尺寸:比Place_bound略小(0~10 mil),表贴类是贴着Place_Bound的边界。
放置装配层(Assembly)
- 一般跟丝印层一样
放置元件标示符(Labels)
- 标示符包括装配层Assembly_Top和丝印层Silkscreen_Top两个部分,options里的设置也分两部分
放置器件类型(Device,非必要)
- Layout->Labels->Device,Options中选择Assembly_Top,设置器件类型为Reg。
设置封装高度(Package Height,非必要)
- Setup->Areas->Package Height,选中封装,在options中自动弹出Place_Bound_Top,并设置高度的最小和最大值。
1.2.5、生成dra
至此一个电阻的0805封装制作完成,保存退出后在相应文件夹下会找到r0805_1mm2_1mm4.dra和r0805_1mm2_1mm4.psm两个文件。(其中,dra文件是用户可操作的,psm文件是PCB设计时调用的)。
保存时若提示警告“Sector table not empty. Use dbdoctor to resolve”,则需执行Tools->Database Check,全选即可。
2、DIP封装的制作(直插分立元件)
通孔分立元件主要包括插针的电阻、电容、电感等。本文档将以1/4W的M型直插电阻为例来进行说明。
2.1、制作焊盘
2.1.1、计算焊盘尺寸
假设元件直插引脚直径为:PHYSICAL_PIN_SIZE,则对通孔焊盘的各尺寸如下表所示:

假如引脚直径PHYSICAL_PIN_SIZE =20 mil,Drill Diameter = 32mil,Regular Pad = 48mil,Anti-pad = 68mil,Inner Diameter = 52mil,Outer Diameter = 68mil,Spoke width = 18mil。
2.1.2、热风焊盘Thermal Relief制作
建DIP焊盘之前必须设置参数如下:
Setup->Design Parameters->Design->Left X: -10000, Lower Y: -10000,-10000可以根据具体情况选取,设置的目的在于防止Add->Flash时报错“Arc segment is outside of the extents”。
热风焊盘最后是要放在通孔焊盘的中间层,生成dra和fsm。
File->New,在New Drawing对话框中选择Flash symbol,命名一般以其外径和内径命名,这里设为TR_68_52,如下图所示。
注意,Flash符号是直插类焊盘调用的,SMD焊盘不调用。
Add->Flash,并在填入Inner Diameter、Outer Diameter和Spoke width,如下图所示。
Setup->User Preferences->Paths->Library->psmpath中设置要使用的焊盘路径
2.1.3 、通孔焊盘制作(生成.pad)
Pad Designer->File->New-> pad48cir32d
其中,48表示外直径(Regular Pad),cir表示圆形,32表示内直径(Drill Diameter),d表示镀锡,用在需要电气连接的焊盘或过孔,若是u则表示不镀锡,一般用于固定孔。
Plated是指钻孔壁加镀锡,镀锡用在需要电气连接的焊盘或过孔,不镀锡一般用于固定孔。
- Regular Pad,正规焊盘,在正片中看到的焊盘,也是通孔焊盘的基本焊盘。
- 隔热焊盘(Thermal Relief)也叫热风焊盘和花焊盘,在负片(所谓负片就是在片中看到的就是要被腐蚀掉的,看不到的就是要保留下来的)中有效。
- 隔离焊盘(Anti Pad),也是在负片中有效,用于在负片中焊盘与敷铜的隔离。
顶层(BEGIN LAYER)的设置
- Regular Pad的Width和Height与Regular Pad的直径 (48 mil) 相同,Geometry选择Circle,Width填入48mil即可;
- Thermal Pad必须选择Flash,并选择刚制作的热风焊盘TR_68_52,此时会自动弹出Width (68) 和Height (68) ;
- Anti Pad的Width和Height设置与Thermal Relief相同即可,无论如何,Begin Layer的Thermal Relief和Anti Pad总是比Regular Pad大约20mil (0.5mm) 。
中间层(DEFAULT_INTERNAL)的设置、底层(END_LAYER)的设置
- 与Begin Layer设置相同即可。
阻焊层的设置
- 阻焊层(SOLDERMASK_TOP和SOLDERMASK_BOTTOM),Solder Mask=Regular Pad直径+4~20 mil(焊盘直径越大,这个值也可酌情增大)。
助焊层(可不设置):此层仅用于表贴封装,在直插元件的通孔焊盘中不起作用,可不填。
2.2、制作封装
2.2.1、各层的尺寸约束
除丝印层的形状外,直插分立元件的约束与1.2节基本类似。
对于丝印层,其形状与元件性质有关:
- 对于直插式电阻、电感或二极管,丝印层通常选择矩形框,位于两个焊盘内部,且两端抽头;
- 对于直插式电容,一般选择丝印框在焊盘之外,若是扁平的无极性电容,形状选择矩形;若是圆柱的有极性电容,则选择圆形。
- 对于需要进行标记的,如有极性电容的电容的正端或者二极管的正端等,除却焊盘做成矩形外,丝印层也可视具体情况进行标记。
2.2.2设置参数、栅格grid和原点
2.2.3放置焊盘
2.2.4放置各类标识
放置元件实体区域(Place_Bound)
放置丝印层(Silkscreen)
放置装配层(Assembly)
放置元件标示符(Labels)
放置器件类型(Device,非必要)
设置封装高度(Package Height,非必要)
2.2.5生成dra
3、SMD IC封装的制作
表贴IC是目前电子系统设计过程中使用最为广泛地,本文以集成运放AD8510的SO8为例来进行叙述。其尺寸图如下所示。
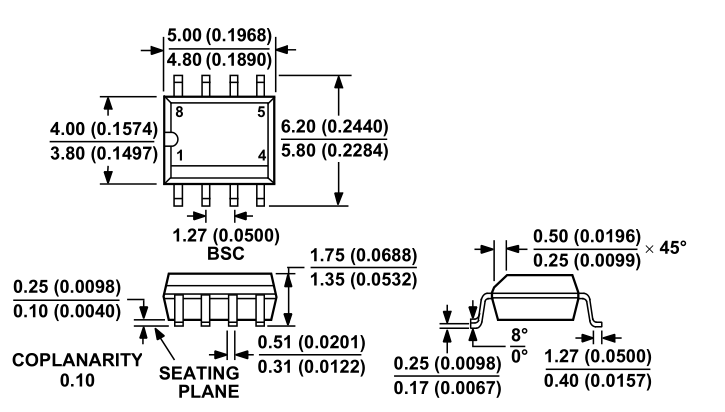
上面单位是mm(inches),1 inch = 1000 mil。
3.1、制作焊盘
3.1.1、计算焊盘尺寸(SOP,SSOP,SOT)
对于如SOP,SSOP,SOT等符合下图的表贴IC。其焊盘取决于四个参数:脚趾长度W,脚趾宽度Z,脚趾指尖与芯片中心的距离D,引脚间距P,如下图:

上图中的“+”号是芯片的中心点,可理解成PCB的原点。
SOP,SSOP,SOT封装焊盘与PCB焊盘的关系
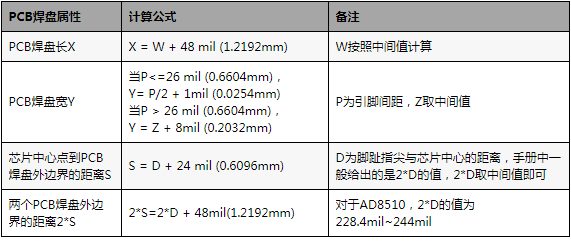
根据上表公式,AD8510的W = (50mil+15.7mil)/2 = 33mil,PCB焊盘长X = 81mil,引脚间距P = 50mil,脚趾宽度Z = 16mil,PCB焊盘宽Y=24mil
3.1.2、计算焊盘尺寸(QFN,QFP,BGA)

上图是QFN封装(来自于ATmega88PA-MU)
上图中焊盘间距e=0.45mm,焊盘宽度b=0.22mm,焊盘长度L=0.40mm,根据下表可知,焊盘宽度X=0.26mm,外延Tout=0.15mm,内沿Tin=0.05mm。
通常情况下,外延取0.25 mm,内延取0.05 mm。

3.1.3、焊盘制作
从上节可知,AD8510的W = (50mil+15.7mil)/2 = 33mil,PCB焊盘长X = 81mil,引脚间距P = 50mil,脚趾宽度Z = 16mil,PCB焊盘宽Y=24mil。
参考AD8056的SO8封装尺寸,W=(16+50)/2=33 mil,P= 50mil,Z=(19.2+13.8)/2=17.5 mil,故而X取80 mil,Y取25 mil。
- Begin Layer(Top层):选择Rectangle,Width = 81mil,Height = 24mil;
- SOLDERMASK_TOP(绿油层):选择Rectangle,Width = 81mil + 4~20mil (0.1mm~0.5mm) ,Height = 24mil+4~20mil (0.1mm~0.5mm) ;
- PASTEMASK_TOP (钢网层) :选择Rectangle,Width = 81mil,Height = 24mil;
3.2、封装制作
3.2.1、各层的尺寸约束
除丝印层外,表贴IC的各层约束规则与2.2.1类似,这里不再赘述。
- 对于丝印层,表贴IC的丝印框与引脚内边间距10mil左右,线宽5mil,形状与该IC的封装息息相关,通常为带有一定标记的矩形(如切角或者打点来表示第一脚)。对于sop等两侧引脚的封装,长度边界取IC的非引脚边界即可。丝印框内靠近第一脚打点标记,丝印框外,第一脚附近打点标记,打点线宽视元件大小而定,合适即可。对于QFP和BGA封装(引脚在芯片底部的封装),一般在丝印框上切角表示第一脚的位置。
2.2.2设置参数、栅格grid和原点
芯片中心点到PCB焊盘外边界的距离S,2xS=2xD + 48mil,2xD = (228.4mil+244mil)/2,所以D = 118.1mil, S = D + 24mil = 142mil,PCB焊盘长X = 81mil,S-X/2 = 102mil
参考AD8056的SO8封装尺寸,D=(228.4+244)/4=118.1 mil,故而S=142 mil,取140 mil。与2.2.2中重复的部分这里不再赘述。
2.2.3放置焊盘
可以批量放置焊盘
2.2.4放置各类标识
放置元件实体区域(Place_Bound)
放置丝印层(Silkscreen)
放置装配层(Assembly)
放置元件标示符(Labels)
放置器件类型(Device,非必要)
设置封装高度(Package Height,非必要)
2.2.5生成dra
4、DIP IC封装的制作
首先说明,DIP IC的第一脚一般用正方形,其他脚用圆形,但是这里不介绍IC,以SKHHLNA010为例进行说明。
通孔焊盘设计过程与2.1节类似,区别在于对于通孔IC,一般会用一个特殊形状的通孔来表示第一脚,这里第一脚的焊盘用正方形,其他为圆形。

SKHHLNA010的尺寸图(unit:mm)
SKHHLNA010的引脚直径(实际并非圆柱体)不一样,所以需要两种通孔焊盘。较小的引脚长宽分别为0.7x0.3mm,此引脚的直径按照0.7mm计算;较大的引脚长宽分别为1x1mm,此引脚的直径按照1mm计算。上图中较小引脚的间距为4.5mm = 180mil,较大引脚的间距为7mm = 280mil,较小引脚与较大引脚的间距为2.5mm = 100mil。
因此我们可以定义两个焊盘。
4.1、制作焊盘
4.1.1、计算焊盘尺寸
设元件直插引脚直径为:PHYSICAL_PIN_SIZE,则对应的通孔焊盘的各尺寸如下:

根据上面表格的公式,对于较大的引脚,PHYSICAL_PIN_SIZE = 1mm = 40mil,Drill Diameter = 52mil, Regular Pad = 82mil,Anti-pad = 102mil,Inner Diameter = 72mil,Outer Diameter = 102mil,Spoke width = 25mil;
对于较小的引脚,PHYSICAL_PIN_SIZE = 0.7mm = 28mil,Drill Diameter = 40mil, Regular Pad = 56mil,Anti-pad = 76mil,Inner Diameter = 60mil,Outer Diameter = 76mil,Spoke width = 18mil;
4.1.2、热风焊盘Thermal Relief制作
建DIP焊盘之前必须设置参数如下:
Setup->Design Parameters->Design->Left X: -10000, Lower Y: -10000,-10000可以根据具体情况选取,设置的目的在于防止Add->Flash时报错“Arc segment is outside of the extents”。
首先建立较大引脚的热风焊盘TR_102_72mil。
其次建立较小引脚的热风焊盘TR_76_60mil。
4.1.3、通孔焊盘制作(大焊盘)
首先建立较大引脚的通孔焊盘pad82cir52d。
Pad Designer->File->New-> pad82cir52d。
上面命名是因为Drill Diameter = 52mil, Regular Pad = 82mil,cir表示圆形焊盘,d表示镀锡,若是u则表示不镀锡。然后,Parameters选项中设置Drill Diameter (52mil),Drill/Slot symbol中Figure选择Circle,Characters填入_S_(可随意选择),Width=10.0,Height=10.0。
之后设置Layers选项。
BEGIN LAYER的Regular Pad的Width和Height等于Regular Pad(82mil);
BEGIN LAYER的Therm Relief选择Flash,同时添加Tr_102_72Mil;
BEGIN LAYER的Anti Pad的Width和Height设置与Thermal Relief相同即可
DEFAULT_INTERNAL和END_LAYER设置与BEGIN LAYER相同即可。
最后保存为pad82cir52d.pad即可。
4.1.4、通孔焊盘制作(小焊盘)
其次建立较小引脚的通孔焊盘pad56cir40d。
Pad Designer->File->New-> pad56cir40d
上面命名是因为Drill Diameter = 40mil, Regular Pad = 56mil,cir表示圆形焊盘,d表示镀锡,若是u则表示不镀锡。然后,Parameters选项中设置Drill Diameter (40mil),Drill/Slot symbol中的Figure若设置为NULL,在保存时会报警告“NCDRILL: Drill hole is defined”,因此Figure选择Circle,Characters填入_S_(可随意选择),Width=10.0,Height=10.0。
之后设置Layers选项。
BEGIN LAYER的Regular Pad的Width和Height等于Regular Pad(56mil);
BEGIN LAYER的Therm Relief选择Flash,同时添加Tr_76_60Mil;
BEGIN LAYER的Anti Pad的Width和Height设置与Thermal Relief相同即可,
最后保存为pad56cir40d.pad即可。
PCB Editor->Setup->User Preferences->Paths->Library->padpath中添加要使f的焊盘路径。
4.2、封装制作
4.2.1设置参数、栅格grid和原点
PCB_Editor->File->New->Package symbol,Drawing Name填入SKHHLNA010 (.dra)
之后点开并固定Allegro右侧的Options,选择Layout->Pins,在Options中选择此次要使用的padstack。首先将几个关键参数列在下面。
较小引脚的间距为4.5mm = 180mil,较大引脚的间距为7mm = 280mil,较小引脚与较大引脚的间距为2.5mm = 100mil。
4.2.2放置焊盘
可以批量放置焊盘
4.2.3放置各类标识
放置元件实体区域(Place_Bound)
放置丝印层(Silkscreen)
放置装配层(Assembly)
放置元件标示符(Labels)
放置器件类型(Device,非必要)
设置封装高度(Package Height,非必要)
4.2.4生成dra
5、总结
封装制作完毕后,记得一定要对照数据手册检查。
参考链接:https://blog.csdn.net/LIYUANNIAN/article/details/82718734
https://www.cnblogs.com/dongfengweixiao/p/5819625.html
参考书籍:cadence高速电路板设计与仿真(第六版)-原理图与PCB设计

